北大团队首创硒化铟晶圆,性能超越硅芯片
近日,北京大学刘开辉教授领衔的联合团队在《science》上发表有关半导体材料的题为《Two-dimensional indium selenide wafers for integrated electronics》的文章,该文章提到团队研发的全球首创固-液-固(SLS)生长技术,成功制备5厘米二维硒化铟(InSe)单晶晶圆。该技术为二维硒化铟在大规模集成电子领域的应用奠定了基础,有望推动先进晶体管的发展。
.png)
二维硒化铟(2D InSe)具有低有效质量、高热速度和优异的电子迁移率,是一种有望超越硅基电子器件的极具潜力的半导体材料,但目前生长的薄膜性能仍无法与剥离的微米级薄片相比。北京大学刘开辉教授领衔的联合团队报道了一种固-液-固策略(SLS),通过创建富铟液体界面并维持铟与硒1:1的严格化学计量比,将非晶硒化铟薄膜转化为纯相、高结晶度的硒化铟晶圆。所获得的硒化铟薄膜在整个约 5 厘米的晶圆上表现出卓越的均匀性、纯相特性和高结晶度。基于这些硒化铟晶圆制备的晶体管阵列展现出超越所有二维薄膜器件的优异电子性能,包括室温下极高的迁移率(平均高达287 cm2/V·s)和接近玻尔兹曼极限的亚阈值摆幅(平均低至 67 mV/dec)。
人工智能和物联网技术的进步对计算能力提出了极高需求,但硅基晶体管技术在亚 10 nm节点正接近其固有的物理极限,限制了芯片性能、能效和集成密度的进一步提升,因此亟需能克服硅局限性的新型半导体沟道材料。二维原子级薄半导体(如MoS2、WS2、WSe2和InSe等)是亚3nm技术节点的候选材料,其中硒化铟理论上可超越硅的限制,但其大规模集成电子器件的应用最终依赖于大规模、高质量的硒化铟晶圆。
目前,晶圆级硒化铟薄膜主要通过金属有机化学气相沉积、分子束外延等薄膜沉积技术制备,但生长的薄膜性能欠佳,甚至不及二维过渡金属硫族化合物半导体。高质量硒化铟薄膜生长面临两大挑战:一是铟-硒体系相多样性复杂,至少存在四种稳定相,轻微的成分变化就会引发不期望的相变,导致性能显著偏差和退化;二是由于生长温度约 500°C 时硒的蒸气压比铟高约7个数量级,难以维持铟与硒的化学计量平衡,导致薄膜结晶度较差。
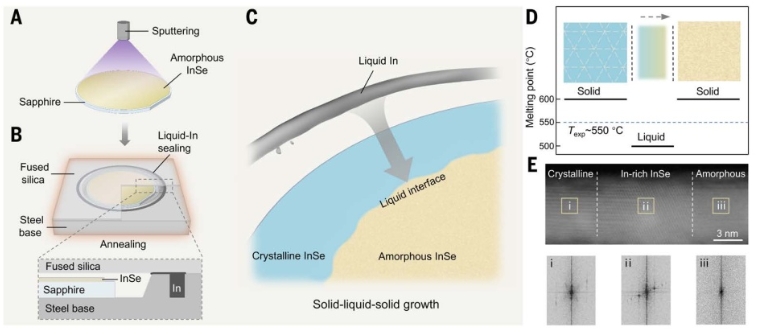
因此,该团队通过密封预先沉积的非晶硒化铟晶圆来维持铟与硒1:1的严格化学计量比,并利用SLS生长机制实现高结晶度。他们在约 5 厘米蓝宝石衬底上制备出高质量硒化铟晶圆,薄膜厚度与溅射时间近乎线性相关,最小可达约 2.5 nm(三层)。表征结果显示,薄膜从非晶态到晶态的表面粗糙度显著降低,约 5 cm晶圆上 12 个代表性区域的光学图像和拉曼光谱一致,证明其大面积均匀性,且该方法可扩展至 10 cm晶圆的生产。
基于该晶圆的晶体管阵列及短沟道器件表现出卓越的电子性能,不仅平均迁移率和亚阈值摆幅等参数超越现有二维薄膜器件,满足先进集成技术需求,且超短沟道(10 nm)硒化铟晶体管的关键参数 —— 包括工作电压、栅长、漏致势垒降低(DIBL)、有效质量、开关比和弹道比 —— 均超过了当前最先进的英特尔3纳米节点技术,该器件的延迟和能量延迟积(EDP)低于 2037 年国际器件与系统路线图(IRDS)对硅技术的预测极限,展现出在下一代电子器件中的巨大潜力。








